Kaynak:https://link.springer.com/chapter/10.1007/978-3-319-48933-9_13

Bir süredir yarı iletken endüstrisinde baskın malzeme olan ve olmaya devam edecek olan silikon[13.1], bizi ultra büyük ölçekli entegrasyon (ULSI) çağına ve çipte sistem (SOC) çağına taşıyacak.
Elektronik cihazlar daha gelişmiş hale geldikçe, cihaz performansı onları oluşturmak için kullanılan malzemelerin kalitesine ve özelliklerine daha duyarlı hale geldi.
Germanyum (Ge), başlangıçta katı hal elektronik cihazları için yarı iletken malzeme olarak kullanılmıştır. Bununla birlikte, Ge'nin dar bant aralığı (0.66 eV), germanyum bazlı cihazların çalışmasını yaklaşık 90 derecelik sıcaklıklarla sınırlar.∘C, daha yüksek sıcaklıklarda gözlenen önemli kaçak akımlar nedeniyle. Silikonun daha geniş bant aralığı (1.12 eV), diğer yandan, elektronik cihazlara kadar çalışabilen elektronik cihazlarla sonuçlanır.. Bununla birlikte, dar bant aralığından daha ciddi bir sorun vardır: Germanyum, yüzeyde kolayca kararsız pasivasyon tabakası sağlamaz. Örneğin, germanyum dioksit (GeO2) suda çözünür ve yaklaşık 800'de ayrışır.∘C. Silisyum, germanyumun aksine, silikon dioksit (SiO) oluşturarak yüzey pasivasyonunu kolayca barındırır.2), temel alınan cihaza yüksek derecede koruma sağlar. Bu kararlı SiO2katman, elektronik cihaz üretimi için kullanılan temel yarı iletken malzeme olarak germanyuma göre silikon için kesin bir avantaj sağlar. Bu avantaj, difüzyon dopingi ve karmaşık kalıpları tanımlama süreçleri de dahil olmak üzere bir dizi yeni teknolojiye yol açmıştır. Silisyumun diğer avantajları, tamamen toksik olmaması ve silikanın (SiO2), silikonun elde edildiği hammadde yaklaşık 60%Yerkabuğunun mineral içeriği. Bu, silikonun elde edildiği hammaddenin entegre devreye bol miktarda tedarik edildiği anlamına gelir (IC) sanayi. Ayrıca, elektronik dereceli silikon, germanyum maliyetinin onda birinden daha az bir fiyata elde edilebilir. Tüm bu avantajlar, yarı iletken endüstrisinde silikonun neredeyse tamamen germanyumun yerini almasına neden oldu.
Silikon her elektronik cihaz için en uygun seçim olmasa da avantajları, yarı iletken endüstrisine bir süre daha kesinlikle hakim olacağı anlamına geliyor.
1947'de nokta temaslı transistörün icadından bu yana, yarı iletken malzeme kullanıcıları ve üreticileri arasında çok verimli etkileşimler meydana geldi.mükemmel ve safkristaller tanındı. Rekabet genellikle öyleydi ki, yeni cihazlar tarafından talep edilen kristal kalitesi ancak bu yeni cihazlarla yapılan elektronik teçhizat kullanılarak kristal büyümesinin kontrol edilmesiyle karşılanabilirdi. Dislokasyonsuz silikon kristalleri 1960'lardaÇizgi tekniği[13.2], yarı iletken malzeme araştırma ve geliştirme çabaları, malzeme saflığı, üretim verimleri ve cihaz üretimi ile ilgili sorunlar üzerinde yoğunlaşmıştır. Tipik yarı iletken silikon hazırlama işlemleri için akış şeması. (Sonra[13.1]) DRAM üretiminin bir fonksiyonu olarak gofret başına yongalar. (Sonra[13.3]) Bu bölümde, ham maddenin tek kristalli silikona dönüştürülmesiyle silisyumun hazırlanmasına yönelik güncel yaklaşımlar (bkz.13.1)- tartışıldı. Bir sonraki adım, MG-Si'yi, tek kristalli silikon için başlangıç malzemesi olarak kullanılan yarı iletken dereceli silikon (SG-Si) seviyesine kadar saflaştırmaktır. Temel konsept, toz haline getirilmiş MG-Si'nin, sıvılaştırılmış yataklı reaktörde çeşitli klorosilan bileşikleri oluşturmak için susuz HC1 ile reaksiyona sokulmasıdır. Daha sonra silanlar damıtma ve kimyasal buhar biriktirme ile saflaştırılır (özgeçmiş) SG-polisilikon oluşturmak için. 1. Susuz hidrojen klorürün MG-Si ile oldukça düşük sıcaklıklarda (200-400) reaksiyonuyla kolayca oluşturulabilir.∘C). 2. Oda sıcaklığında sıvıdır, bu nedenle standart damıtma teknikleri kullanılarak saflaştırma gerçekleştirilebilir. 3. Kullanımı kolaydır ve kuruduğunda karbon çelik tanklarda saklanabilir. 4. Sıvı triklorosilan kolayca buharlaşır ve hidrojen ile karıştırıldığında çelik hatlarda taşınabilir. 5. Hidrojen varlığında atmosfer basıncında indirgenebilir. 6. Oluşan silikonu kirletebilecek herhangi bir yabancı yüzeyle temas ihtiyacını ortadan kaldırarak, ısıtılmış silikon üzerinde birikebilir. 7. Daha düşük sıcaklıklarda reaksiyona girer (1000–1200∘C) ve silikon tetraklorürden daha hızlıdır. Söylemeye gerek yok, ince çubukların saflığı, bırakılan silikonunkiyle karşılaştırılabilir olmalıdır. İnce çubuklar yaklaşık 400 dereceye kadar önceden ısıtılır.∘Silikon CVD işleminin başlangıcında C. Bu ön ısıtma, yüksek saflıkta (yüksek dirençli) ince çubukların iletkenliğini, dirençli ısıtmaya izin verecek kadar yeterince artırmak için gereklidir. 1100 civarında 200–300 saat yatırma∘C, 150–200 mm çapında yüksek saflıkta polisilikon çubuklarla sonuçlanır. Polisilikon çubuklar, Czochralski eriyik büyümesi için topaklar ve yüzer bölge büyümesi için uzun silindirik çubuklar gibi sonraki kristal büyüme süreçleri için çeşitli biçimlerde şekillendirilir. Hidrojen kullanılarak ısıtılmış silikon çubuk üzerinde triklorosilanın indirgenmesi işlemi, 1950'lerin sonlarında ve 1960'ların başlarında Siemens'e verilen bir dizi işlem patentinde anlatılmıştır; bu nedenle, bu süreç genellikle denirSiemens yöntemi[13.4]. Siemens yönteminin en büyük dezavantajları, zayıf silikon ve klor dönüşüm verimliliği, nispeten küçük parti boyutu ve yüksek güç tüketimidir. Silisyum ve klorun zayıf dönüşüm verimleri, CVD işleminde yan ürün olarak üretilen büyük hacimli silikon tetraklorür ile ilişkilidir. Sadece yaklaşık 30%CVD reaksiyonunda sağlanan silikonun yüzdesi, yüksek saflıkta polisilikon'a dönüştürülür. Ayrıca, yüksek saflıkta polisilikon üretmenin maliyeti, yan ürün olan SiCl'nin kullanışlılığına bağlı olabilir.4. Monosilan üretimi ve pirolizine dayanan Apolisilikon üretim teknolojisi 1960'ların sonlarında kurulmuştur. Monosilan, polisilikonu daha düşük sıcaklıkta biriktirdiği ve triklorosilan işleminden daha saf polisilikon ürettiği için potansiyel olarak enerji tasarrufu sağlar; bununla birlikte, monosilan için ekonomik bir yolun olmaması ve biriktirme adımındaki işleme problemlerinden dolayı pek kullanılmamıştır[13.5]. Bununla birlikte, son zamanlarda yüksek saflıkta silana ekonomik yolların geliştirilmesi ve büyük ölçekli tesisin başarılı bir şekilde işletilmesi ile bu teknoloji, daha yüksek saflıkta silikon gerektiren yarı iletken endüstrisinin dikkatini çekmiştir. Mevcut endüstriyel monosilan proseslerinde magnezyum ve MG-Si tozu 500 dereceye kadar ısıtılır.∘Magnezyum silisit (Mg) sentezlemek için ahidrojen atmosferi altında C2Si), daha sonra amonyum klorür (NH) ile reaksiyona girmesi için yapılır.4Cl) sıvı amonyak içinde (NH3) 0'ın altında∘C monosilan oluşturmak için (SiH4). Yüksek saflıkta polisilikon daha sonra 700-800'de dirençli olarak ısıtılan polisilikon filamentler üzerinde monosilanın pirolizi yoluyla üretilir.∘C. Monosilan üretim sürecinde, bor safsızlıklarının çoğu, NH ile kimyasal reaksiyon yoluyla silandan uzaklaştırılır.3. Polisilikonda 0,01-0,02 ppba'lık aboron içeriği, amonosilan işlemi kullanılarak elde edilmiştir. Bu konsantrasyon, triklorosilandan hazırlanan polisilikonda gözlenene kıyasla çok düşüktür. Ayrıca, elde edilen polisilikon, monosilan ayrışması herhangi bir korozyon sorununa neden olmadığı için, kimyasal taşıma işlemleri yoluyla toplanan metallerle daha az kirlenir. Serbest akışlı granüler polisilikon üretmek için akışkan yataklı çökeltme reaktöründe monosilanın ayrışmasını kullanan önemli ölçüde farklı bir süreç geliştirilmiştir[13.5]. Minik silikon tohum parçacıkları, amonosilanlar-hidrojen karışımı içinde akışkanlaştırılır ve polisilikon, 100-1500 um boyut dağılımı ile ortalama 700 um çapında serbest akışlı küresel parçacıklar oluşturmak üzere biriktirilir. Akışkan yataklı tohumlar orijinal olarak SG-Si'nin bilyeli veya çekiçli değirmende öğütülmesi ve ürünün asit, hidrojen peroksit ve su ile süzülmesiyle yapılmıştır. Bu süreç zaman alıcı ve maliyetliydi ve metal öğütücüler aracılığıyla sisteme istenmeyen yabancı maddeleri sokma eğilimindeydi. Bununla birlikte, yeni bir yöntemde, büyük SG-Si partikülleri, yüksek hızlı bir gaz akışı ile birbirlerine ateşlenerek, akışkan yatak için uygun boyutta partiküllere ayrılmalarına neden olur. Bu işlem hiçbir yabancı madde getirmez ve liç gerektirmez. Granüler polisilikon daha büyük yüzey alanı nedeniyle, akışkan yataklı reaktörler, geleneksel Siemens tipi çubuk reaktörlerden çok daha verimlidir. Akışkan yataklı polisilikon kalitesinin, daha geleneksel Siemens yöntemiyle üretilen polisilikon kalitesine eşdeğer olduğu gösterilmiştir. Ayrıca, serbest akışlı formdaki granüler polisilikon ve yüksek kütle yoğunluğu, kristal yetiştiricilerin her üretim çalışmasından en iyi şekilde yararlanmalarını sağlar. Yani, Czochralski kristal büyüme sürecinde (aşağıdaki bölüme bakınız), potalar, Siemens yöntemiyle üretilen rastgele istiflenmiş polisilikon parçalarını tipik olarak aşan tek biçimli yüklemelere hızlı ve kolay bir şekilde doldurulabilir. Tekniğin toplu işlemden sürekli çekmeye geçme potansiyelini de göz önünde bulundurursak (daha sonra tartışılacaktır), serbest akışlı polisilisyum granüllerin, sabit durum eriyiğine tek biçimli beslemenin avantajlı yolunu sağlayabileceğini görebiliriz. Bu ürün, silikon kristal büyümesi için büyük umut vaat eden devrim niteliğinde bir başlangıç malzemesi gibi görünüyor. Tek kristal büyüme ilkeleri (a)yüzer bölge yöntemi ve (b)Czochralski yöntemi. (Sonra[13.1]) 95 civarında olduğu tahmin edilmektedir.%tüm tek kristal silisyumun tamamı CZ yöntemiyle, geri kalanı ise esas olarak FZ yöntemiyle üretilir. Silikon yarı iletken endüstrisi, cihaz üretim verimini ve operasyonel performansı optimize etmek için silikon kristallerinde yüksek saflık ve minimum kusur konsantrasyonları gerektirir. Teknoloji LSI'dan VLSI∕ULSI'ye ve ardından SOC'ye değiştikçe bu gereksinimler giderek daha katı hale geliyor. Silikon kristallerinin kalitesi veya mükemmelliğinin yanı sıra, cihaz üreticilerinin taleplerini karşılamak için kristal çapı da istikrarlı bir şekilde artmaktadır. Mikroelektronik çipler bir sistem aracılığıyla üretildiğindenParti sistemi, cihaz üretimi için kullanılan silikon gofretlerin çapları, üretkenliği önemli ölçüde etkiler (Şekil 2'de gösterildiği gibi).13.2) ve sırayla üretim maliyeti. Aşağıdaki bölümlerde, önce FZ yöntemini tartışacağız ve ardından CZ yöntemine geçeceğiz. İkincisi, mikroelektronik endüstrisi için aşırı önemi nedeniyle daha ayrıntılı olarak tartışılacaktır. FZ yöntemi, ikili alaşımları rafine etmek için kullanılan bölge eritmesinden kaynaklanmıştır[13.6] tarafından icat edildiTheuerer[13.7]. Pota için kullanılan malzeme ile sıvı silikonun reaktivitesi, FZ yönteminin geliştirilmesine yol açmıştır[13.8], gerekli yarı iletken saflığındaki kristalleri büyütebilmek için gerekli olan pota malzemesi ile herhangi bir temasa gerek kalmadan silikonun kristalleşmesine izin verir. FZ işleminde, apolysilikon çubuk, Şekil l'de gösterildiği gibi, iğne-göz bobini tarafından ısıtılan erimiş bölgeyi çubuğun bir ucundan diğerine geçirerek tek kristalli külçeye dönüştürülür.13.3bir. İlk olarak, polisilikon çubuğun ucu temas ettirilir ve arzu edilen kristal oryantasyonu ile çekirdek kristali ile kaynaştırılır. Bu süreç denirtohumlama. Çekirdeklenmiş erimiş bölge, tek kristal tohumu aynı anda çubuktan aşağı hareket ettirerek polisilikon çubuktan geçirilir. Silisyumun erimiş bölgesi katılaştığında, polisilikon tohum kristali yardımıyla tek kristalli silikona dönüştürülür. Bölge polisilikon çubuk boyunca hareket ederken, tek kristalli silikon ucunda donar ve tohum kristalinin bir uzantısı olarak büyür. Yüzen bölge silikonunun tohum, boyun ve konik kısmının X-ışını topografisi. (Dr. T. Abe'nin izniyle) Yüzen bölge silikon kristali için destek sistemi. (Sonra[13.9]) Gerekli özdirençte n- ya da p-tipi silikon tek kristallerini elde etmek için, ya polisilikon ya da büyüyen kristal, sırasıyla uygun verici ya da alıcı safsızlıklar ile katkılanmalıdır. FZ silikon büyümesi için, birkaç doping tekniği denenmiş olmasına rağmen, kristaller tipik olarak fosfin (PH) gibi adopant gaz üfleyerek katkılanır.3) n-tipi silikon veya diboran için (B2H6) erimiş bölge üzerine p-tipi silikon için. Dopant gazı genellikle argon gibi taşıyıcı gaz ile seyreltilir. Bu yöntemin en büyük avantajı, silikon kristal üreticisinin farklı özdirençlere sahip polisilikon kaynaklarını depolamasına gerek olmamasıdır. NTD'nin uygulanması, CZ kristallerine kıyasla daha yüksek saflıklarından dolayı neredeyse yalnızca FZ kristalleri ile sınırlandırılmıştır. CZ silikon kristallerine NTD tekniği uygulandığında, fosfor donör homojenliği sağlanmış olmasına rağmen, ışınlama sonrası tavlama işlemi sırasında oksijen donörü oluşumunun direnci beklenenden değiştirdiği bulundu.13.11]. NTD, p-tipi katkı maddeleri için hiçbir işlemin mevcut olmaması ve düşük özdirençler için (1-10 Ω cm aralığında) aşırı uzun bir ışınlama süresinin gerekli olması gibi ek bir eksikliğe sahiptir. FZ kristal büyümesi sırasında, erimiş silikon, büyüme odasındaki ortam gazı dışında herhangi bir madde ile temas etmez. Bu nedenle, bir FZ silikon kristali, aquartz pota ile temas içeren eriyikten büyütülen aCZ kristaline kıyasla doğal olarak daha yüksek saflığı ile ayırt edilir. Bu temas, yaklaşık 10'luk yüksek oksijen safsızlık konsantrasyonlarına yol açar.18atomlar ∕ cm3CZ kristallerinde, FZ silikon 10'dan az içerir16atomlar ∕ cm3. Bu daha yüksek saflık, FZ silikonunun, CZ silikon kullanılarak elde edilemeyen yüksek dirençlere ulaşmasını sağlar. Tüketilen FZ silisyumunun çoğu 10 ile 200 Ω cm arasında direnç gösterirken, CZ silikon genellikle kuvars potadan kaynaklanan kirlenme nedeniyle 50 Ω cm veya daha az özdirençlere hazırlanır. Bu nedenle FZ silikon esas olarak 750-1000 V'u aşan ters voltajları destekleyen yarı iletken güç cihazlarının imalatında kullanılır. NTD FZ-Si'nin yüksek saflıkta kristal büyümesi ve hassas doping özellikleri, aynı zamanda kızılötesi dedektörlerde kullanılmasına da yol açmıştır[13.12], Örneğin. Bununla birlikte, mekanik gücü dikkate alırsak, CZ silikondan daha az oksijen kirliliği içeren FZ silikonun mekanik olarak daha zayıf olduğu ve cihaz üretimi sırasında termal strese karşı daha savunmasız olduğu yıllardır kabul edilmektedir[13.13,13.14]. Elektronik cihaz üretimi sırasında silikon gofretlerin yüksek sıcaklıkta işlenmesi, genellikle kayma dislokasyonları ve eğrilme oluşturmak için yeterli termal stres üretir. Bu etkiler, sızdıran bağlantılar, dielektrik kusurlar ve azalan ömür nedeniyle verim kaybına ve ayrıca gofret düzlüğünün bozulmasından dolayı fotolitografik verimlerin azalmasına neden olur. Çarpılma nedeniyle geometrik düzlemsellik kaybı o kadar şiddetli olabilir ki, gofretler daha fazla işlenmez. Bu nedenle, CZ silikon gofretler, IC cihaz imalatında FZ gofretlerinden çok daha yaygın olarak kullanılmıştır. Termal streslere karşı mekanik stabilitedeki bu fark, CZ silikon kristallerinin çok sayıda termal işlem adımı gerektiren IC'lerin üretimi için özel olarak kullanılmasının baskın nedenidir. FZ silikonun bu eksikliklerinin üstesinden gelmek için, oksijen gibi doping safsızlıkları ile FZ silikon kristallerinin büyümesi[13.15] ve nitrojen[13.16] denendi. FZ silikon kristallerinin oksijen veya nitrojen ile aşağıdaki konsantrasyonlarda katkılandığı bulundu.veyasırasıyla, mekanik mukavemette belirgin bir artışa neden olur. Bu yöntem, metallerin kristalleşme hızlarını belirlemek için bir teknik geliştiren J. Czochralski'nin adını almıştır.13.17]. Bununla birlikte, tek kristal büyümesine yaygın olarak uygulanan gerçek çekme yöntemi, tarafından geliştirilmiştir.deniz mavisiveküçük[13.18], Czochralski'nin temel ilkesini değiştiren. 1950'de 8 inç uzunluğunda ve 0.75 inç çapında tek germanyum kristallerini başarılı bir şekilde yetiştiren ilk kişilerdi. Daha sonra, daha yüksek sıcaklıklarda silikonun büyümesi için başka bir cihaz tasarladılar. Tek kristal silikon için temel üretim süreci, Teal ve çalışma arkadaşları tarafından öncülük edildiğinden bu yana çok az değişmiş olsa da, son teknoloji ürünü cihazı karşılayan yüksek derecede mükemmelliğe sahip büyük çaplı (400 mm'ye kadar) silikon tek kristaller Dash tekniği ve ardışık teknolojik yenilikler aparata dahil edilerek talepler büyütüldü. Silisyum kristalleriyle ilgili günümüzün araştırma ve geliştirme çabaları, bu El Kitabında başka bir yerde tartışılacak olan özdirenç ve safsızlıkların ve mikro kusurların konsantrasyonları ve bunların mikroskobik kontrolü gibi kristal özelliklerinin mikroskobik tekdüzeliğini elde etmeye yöneliktir. 1. Polisilikon parçaları veya taneleri, aquartz potaya yerleştirilir ve silikonun erime noktasından daha yüksek sıcaklıklarda eritilir (1420).∘C) inert bir ortam gazında. 2. Eriyik tamamen erimesi ve boşluklara veya negatif kristal kusurlarına neden olabilecek küçük kabarcıkların eriyikten dışarı atılması için eriyik bir süre yüksek sıcaklıkta tutulur. 3. İstenen kristal oryantasyonuna sahip tohum kristali, kendi kendine erimeye başlayana kadar eriyiğin içine daldırılır. Tohum daha sonra eriyikten çekilir, böylece çap yavaş yavaş azaltılarak boyun oluşturulur; bu en hassas adımdır. Tüm kristal büyüme süreci boyunca, inert gaz (genellikle argon), SiO ve CO gibi reaksiyon ürünlerini taşımak için çekme odasından aşağı doğru akar. 4. Kristal çapı kademeli olarak artırılarak konik kısım ve omuz büyütülür. Çekme hızı ve/veya eriyik sıcaklığı düşürülerek çap hedef çapa kadar artırılır. 5. Son olarak, gövdenin sabit çaplı silindirik kısmı, kristal büyüdükçe eriyik seviyesindeki düşüşü telafi ederken, çekme hızı ve eriyik sıcaklığı kontrol edilerek büyütülür. Eriyik seviyesi düştükçe ve büyüyen kristale daha fazla pota duvarı maruz bıraktıkça, esas olarak pota duvarından artan ısı radyasyonu nedeniyle çekme hızı genellikle büyüyen kristalin kuyruk ucuna doğru azalır. Büyüme sürecinin sonuna yakın, ancak pota erimiş silikondan tamamen boşalmadan önce, kuyruk ucunda kayma çıkıklarına neden olabilecek termal şoku en aza indirmek için kristal çapı bir uç koni oluşturmak üzere kademeli olarak azaltılmalıdır. Çap yeterince küçüldüğünde, kristal dislokasyon oluşturmadan eriyikten ayrılabilir. Tipik Czochralski silikon kristal yetiştirme sisteminin şematik görünümü. (Sonra[13.1]) Büyütülmüş Czochralski silikon kristalinin tohum ucu kısmı Ekstra büyük büyümüş Czochralski silikon külçe 400 mm çapında ve 1800 mm uzunluğunda. (Super Silicon Crystal Research Institute Corporation, Japonya'nın izniyle) İlk ve son aşamalarda Czochralski kristal büyümesi sırasında termal ortam.Oklarısı akışının yaklaşık yönlerini gösterir. (Sonra[13.19]) Ayrıca, hem kristal kusurlarının hem de safsızlıkların düzensiz dağılımı, genellikle CZ kristal büyüme sürecinde kavisli olan kristal-eriyik ara yüzeyinde art arda kristalleştirilen veya katılaşan aCZ kristal silikon eriyikten hazırlanan düz gofretin enine kesiti boyunca meydana gelir. Bu tür homojensizlikler şu şekilde gözlemlenebilir:çizgiler, daha sonra tartışılacaktır. Elektronik cihazlarda kullanılan silikon yarı iletkenlerin özellikleri safsızlıklara karşı çok hassastır. Bu hassasiyet nedeniyle, silikonun elektrik-elektronik özellikleri, az miktarda katkı maddesi eklenerek hassas bir şekilde kontrol edilebilir. Bu katkı hassasiyetine ek olarak, safsızlıklar (özellikle geçiş metalleri) tarafından kontaminasyon, silikonun özelliklerini olumsuz etkiler ve cihaz performansının ciddi şekilde bozulmasına neden olur. Ayrıca, silikon eriyiği ve kuvars pota arasındaki reaksiyon nedeniyle oksijen, CZ silikon kristallerine milyonda onlarca atom seviyelerinde dahil edilir. Kristalde ne kadar oksijen bulunursa bulunsun, silikon kristallerinin özellikleri oksijenin konsantrasyonundan ve davranışından büyük ölçüde etkilenir.13.21]. Ayrıca, CZ çekme ekipmanında kullanılan grafit parçalar nedeniyle, ya polisilikon hammaddelerinden ya da büyüme işlemi sırasında CZ silikon kristallerine karbon da dahil edilir. Ticari CZ silikon kristallerindeki karbon konsantrasyonu normalde 0,1 ppma'dan az olmasına rağmen, karbon oksijenin davranışını büyük ölçüde etkileyen bir safsızlıktır[13.22,13.23]. Ayrıca nitrojen katkılı CZ silikon kristalleri[13.24,13.25] son teknoloji ürünü elektronik cihazların gereksinimlerini karşılayabilecek yüksek mikroskobik kristal kaliteleri nedeniyle son zamanlarda çok dikkat çekti[13.26,13.27]. Ameltten kristalizasyon sırasında, eriyikte bulunan çeşitli safsızlıklar (dopantlar dahil) büyüyen kristale dahil edilir. Katı fazın safsızlık konsantrasyonu, genel olarak olarak bilinen bir fenomen nedeniyle sıvı fazınkinden farklıdır.segregasyon. Çok bileşenli sistemlerin katılaşmasıyla ilişkili denge ayrışma davranışı, bir ikili sistemin karşılık gelen faz diyagramından belirlenebilir.çözünen(kirlilik) ve birçözücü(ana malzeme) bileşenler olarak. Sonuç olarak, katkı konsantrasyonundaki değişiklikten dolayı dirençte değişkenliğe neden olan safsızlık seviyesindeki amaroskopik boylamsal varyasyonun, CZ parti büyüme sürecinin doğasında olduğu açıktır; bunun nedeni segregasyon olgusudur. Ayrıca, safsızlıkların uzunlamasına dağılımı, kristal büyümesi sırasında eriyik en-boy oranı azaldıkça meydana gelen eriyik taşınımının büyüklüğündeki ve doğasındaki değişikliklerden etkilenir. Czochralski silikonunun omuzunda kimyasal aşındırma ile ortaya çıkan büyüme çizgileri Çizgiler, fiziksel olarak safsızlıkların ayrılmasından ve ayrıca nokta kusurlarından kaynaklanır; bununla birlikte, çizgilere pratik olarak, eriyikteki kararsız termal konveksiyon ve asimetrik bir termal ortamda kristal rotasyonu tarafından indüklenen kristal-eriyik ara yüzeyi yakınındaki sıcaklık dalgalanmaları neden olur. Ek olarak, büyüme ekipmanındaki zayıf çekme kontrol mekanizmalarından kaynaklanan mekanik titreşimler de sıcaklık dalgalanmalarına neden olabilir. Eğri kristal-eriyik arayüzü ve farklı kısımlara dilimlenmiş düzlemsel gofretler içeren Czochralski kristal kesitinin şematik gösterimi. (Sonra[13.1]) İstenilen özdirenci elde etmek için özdirenç-konsantrasyon ilişkisine göre belirli miktarda katkı maddesi (verici veya alıcı atomlar) asilikon eriyiğine eklenir. Yüksek oranda katkılı silikon parçacıkları veya yaklaşık 0,01 Ω cm özdirençli parçalar biçiminde katkı maddelerinin eklenmesi yaygın bir uygulamadır, buna dopant fikstürü denir, çünkü ihtiyaç duyulan saf katkı maddesi miktarı, yoğun katkılı silikon malzemeleri (n) dışında yönetilemez derecede küçüktür.+veya p+silikon). 1. Uygun enerji seviyeleri 2. Yüksek çözünürlük 3. Uygun veya düşük yayılım 4. Düşük buhar basıncı. Oksijen ve karbonun Czochralski silikon kristaline dahil edilmesi. (Sonra[13.1]) 1. Büyük çap 2. Düşük veya kontrollü kusur yoğunluğu 3. Düzgün ve düşük radyal direnç gradyanı 4. Optimum başlangıç oksijen konsantrasyonu ve bunun çökeltilmesi. Potadaki eriyik konveksiyon akışı, CZ silikonun kristal kalitesini güçlü bir şekilde etkiler. Özellikle, uygun olmayan büyüme çizgileri, büyüme arayüzünde sıcaklık dalgalanmalarına neden olan kararsız eriyik taşınımı tarafından indüklenir. Manyetik alanın elektriksel olarak iletken sıvıdaki termal konveksiyonu engelleme yeteneği, ilk olarak yatay tekne tekniği ile indiyum antimonidin kristal büyümesine uygulandı[13.28] ve yatay bölge eritme tekniği[13.29]. Bu araştırmalar sayesinde, yeterli güçteki manyetik alanın eriyik taşınımına eşlik eden sıcaklık dalgalanmalarını bastırabileceği ve büyüme çizgilerini önemli ölçüde azaltabileceği doğrulandı. Manyetik alanın büyüme çizgileri üzerindeki etkisi, eriyikteki türbülanslı termal taşınımını azaltma ve dolayısıyla kristal-eriyik ara yüzeyindeki sıcaklık dalgalanmalarını azaltma yeteneği ile açıklanır. Manyetik alanın neden olduğu sıvı akışının sönümlenmesi, akış manyetik akı çizgilerine dik olduğunda indüklenen manyetomotor kuvvetten kaynaklanır, bu da iletken eriyiğin etkin kinematik viskozitesinde bir artışa neden olur. Manyetik alan uygulamalı CZ (MCZ) yöntemi ile silikon kristal büyümesi ilk kez 1980 yılında rapor edilmiştir[13.30]. Başlangıçta MCZ, düşük oksijen konsantrasyonları içeren ve bu nedenle düşük radyal varyasyonlarla yüksek dirençliliğe sahip CZ silikon kristallerinin büyümesi için tasarlanmıştı. Başka bir deyişle, MCZ silikonunun neredeyse yalnızca güç cihazı üretimi için kullanılan FZ silikonunun yerini alması bekleniyordu. O zamandan beri, manyetik alan yönü (yatay veya dikey) ve kullanılan mıknatıs türü (normal iletken veya süper iletken) açısından çeşitli manyetik alan konfigürasyonları geliştirilmiştir[13.31]. Çok çeşitli istenen oksijen konsantrasyonları (düşükten yükseğe) ile üretilen MCZ silikon, farklı cihaz uygulamaları için büyük ilgi görmüştür. MCZ silikonun değeri, yüksek kalitesinde ve oksijen konsantrasyonunu geniş bir aralıkta kontrol etme yeteneğinde yatar; bu, geleneksel CZ yöntemi kullanılarak elde edilemez[13.32] ve gelişmiş büyüme oranı[13.33]. Kristal kalitesi söz konusu olduğunda, MCZ yönteminin yarı iletken cihaz endüstrisi için en uygun silikon kristallerini sağladığına şüphe yoktur. MCZ silikonunun üretim maliyeti, geleneksel CZ silikonundan daha yüksek olabilir, çünkü MCZ yöntemi daha fazla elektrik gücü tüketir ve elektromıknatıslar için ek ekipman ve çalışma alanı gerektirir; ancak, MCZ'nin daha yüksek büyüme oranı dikkate alındığında ve daha küçük alana ihtiyaç duyan ve iletken mıknatıslara kıyasla daha az elektrik gücü tüketen süper iletken mıknatıslar kullanıldığında, MCZ silikon kristallerinin üretim maliyeti, geleneksel CZ silikon kristallerininkiyle karşılaştırılabilir hale gelebilir. Ek olarak, MCZ silikonun geliştirilmiş kristal kalitesi, üretim verimini artırabilir ve üretim maliyetini düşürebilir. Kristal üretim maliyetleri, büyük ölçüde malzemelerin maliyetine, özellikle kuvars potalar için kullanılanların maliyetine bağlıdır. olarak adlandırılan geleneksel CZ işlemindetoplu işlem, kristal tek bir pota yükünden çekilir ve kuvars pota yalnızca bir kez kullanılır ve ardından atılır. Bunun nedeni, her büyüme çalışması sırasında yüksek sıcaklıktan soğuyan az miktarda silikonun potayı çatlamasıdır. Aquartz potasını eriyik ile ekonomik olarak yenilemek için bir strateji, kristal büyüdükçe sürekli olarak besleme eklemek ve böylece eriyiği sabit hacimde tutmaktır. Pota maliyetlerinden tasarruf etmenin yanı sıra, sürekli şarjlı Czochralski (CCZ) yöntemi, silikon kristal büyümesi için ideal bir ortam sağlar. Daha önce bahsedildiği gibi, geleneksel CZ kesikli işlemiyle büyütülen kristallerdeki homojen olmayanların çoğu, kristal büyümesi sırasında eriyik hacmindeki değişiklikten kaynaklanan kararsız kinetiklerin doğrudan bir sonucudur. CCZ yöntemi, yalnızca üretim maliyetlerini düşürmeyi değil, aynı zamanda kristalleri sabit koşullar altında büyütmeyi de amaçlar. Eriyik hacmini sabit bir seviyede tutarak, sabit termal ve eriyik akış koşulları elde edilebilir (bkz.13.9geleneksel CZ büyümesi sırasında termal ortamlardaki değişimi gösteren). Sürekli şarj eden Czochralski yönteminin şematik gösterimi. (Sonra[13.34]) CCZ yöntemi, geleneksel CZ yöntemiyle büyütülen kristaldeki homojen olmamalarla ilgili sorunların çoğunu kesinlikle çözer. Ayrıca, MCZ ve CCZ'nin kombinasyonu (manyetik alan uygulamalı sürekli CZ (MMZ) yöntemi) çok çeşitli mikroelektronik uygulamalar için ideal silikon kristalleri veren nihai kristal büyüme yöntemini sağlaması beklenmektedir[13.1]. Gerçekten de, mikroelektronik cihazlara yönelik yüksek kaliteli silikon kristallerini büyütmek için kullanılmıştır[13.35]. Bununla birlikte, kristalin farklı bölümlerinin farklı termal geçmişlerinin (Şekil 4'te gösterildiği gibi tohumdan kuyruk uçlarına kadar) vurgulanması gerekir.13.9) kristal ideal büyüme yöntemiyle büyütüldüğünde bile dikkate alınmalıdır. Büyütülmüş kristali homojenleştirmek veya termal geçmişte eksenel tekdüzelik elde etmek için, yüksek sıcaklıkta tavlama gibi bir tür son işlem [13.36], kristal için gereklidir. Daha önce bahsedildiği gibi, Dash'in boyun verme işlemi (3–5 mm çapında boyunda büyüyen, Şek.13.7), büyümüş çıkıkları ortadan kaldırdığı için CZ kristal büyümesi sırasında kritik bir adımdır. Bu teknik, 40 yılı aşkın bir süredir endüstri standardı olmuştur. Bununla birlikte, büyük kristal çaplarına yönelik son talepler (& gt; 300 mm, 300 kg'ın üzerinde), ince boyun çapı 3-5 mm olduğundan, büyüyen kristalde dislokasyon oluşturmayan daha büyük çaplı boyunlara ihtiyaç duyulmasına neden olmuştur. bu kadar büyük kristalleri destekleyemez. 200 mm çapında çıkıksız Czochralski silikon kristali Dash boyunlama işlemi olmadan büyütüldü. (a)Tüm vücut, (b)tohum ve koni. (Prof. K. Hoshikawa'nın izniyle) 13.1F. Şimura:Yarı İletken Silikon Kristal Teknolojisi(Akademik, New York 1988)Google Akademik 13.2WC Çizgi: J. Uyg. Fizik29, 736 (1958)Çapraz ReferansGoogle Akademik 13.3K.Takada, H.Yamagishi, H.Minami, M.Imai: İçinde:Yarı İletken Silikon(The Electrochemical Society, Pennington 1998) s.376Google Akademik 13.4JRMcCormic: İçinde:Yarı İletken Silikon(The Electrochemical Society, Pennington 1986) s.43Google Akademik 13.5PA Taylor: Katı Hal Teknolojisi.Temmuz, 53 (1987)Google Akademik 13.6WG Pfann: Çev. Ben. Enst. Min. Metalik. Müh.194, 747 (1952)Google Akademik 13.7CHTheuerer: ABD Patenti 3060123 (1962)Google Akademik 13.8PH Keck, MJE Golay: Fizik. Rev.89, 1297 (1953)Çapraz ReferansGoogle Akademik 13.9W. Keller, A. Mühlbauer:Yüzer Bölge Silikonu(Marcel Dekker, New York 1981)Google Akademik 13.10JM Meese:Yarı İletkenlerde Nötron Dönüşümü Dopingi(Plenum, New York 1979)Çapraz ReferansGoogle Akademik 13.11HMLiaw, CJVarker: İçinde:Yarı İletken Silikon(The Electrochemical Society, Pennington 1977) s.116Google Akademik 13.12ELKern, LSYaggy, JABarker: İçinde:Yarı İletken Silikon(The Electrochemical Society, Pennington 1977) s.52Google Akademik 13.13SM Hu: Uygulama. Fizik Lett.31, 53 (1977)Çapraz ReferansGoogle Akademik 13.14K. Sumino, H. Harada, I. Yonenaga: Jpn. J. Uygulama Fizik19, L49 (1980)Çapraz ReferansGoogle Akademik 13.15K. Sumino, I. Yonenaga, A. Yusa: Jpn. J. Uygulama Fizik19, L763 (1980)Çapraz ReferansGoogle Akademik 13.16T.Abe, K.Kikuchi, S.Shirai: İçinde:Yarı İletken Silikon(The Electrochemical Society, Pennington 1981) s.54Google Akademik 13.17J. Czochralski: Z. Phys. Kimya92, 219 (1918)Google Akademik 13.18GK Teal, JB Little: Fizik. Rev.78, 647 (1950)Google Akademik 13.19W. Zulehner, D. Huber: İçinde:Kristaller 8: Silikon, Kimyasal Dağlama(Springer, Berlin, Heidelberg 1982) s. 1Google Akademik 13.20H. Tsuya, F. Shimura, K. Ogawa, T. Kawamura: J. Electrochem. Soc.129, 374 (1982)Çapraz ReferansGoogle Akademik 13.21F. Shimura (ed.):Silikondaki Oksijen(Akademik, New York 1994)Google Akademik 13.22S. Kishino, Y. Matsushita, M. Kanamori: Appl. Fizik Lett.35, 213 (1979)Çapraz ReferansGoogle Akademik 13.23F. Shimura: J. Appl. Fizik59, 3251 (1986)Çapraz ReferansGoogle Akademik 13.24HD Chiou, J. Moody, R. Sandfort, F. Shimura: VLSI bilim teknolojisi, Proc. 2. İnt. semptom. Çok Büyük Ölçekli İntegral. (The Electrochemical Society, Pennington 1984) s. 208Google Akademik 13.25F. Shimura, RS Hoket: Uygulama. Fizik Lett.48, 224 (1986)Çapraz ReferansGoogle Akademik 13.26A.Huber, M.Kapser, J.Grabmeier, U.Lambert, WvAmmon, R.Pech: İçinde:Yarı İletken Silikon(The Electrochemical Society, Pennington 2002) s.280Google Akademik 13.27GARozgonyi: İçinde:Yarı İletken Silikon(The Electrochemical Society, Pennington 2002) s.149Google Akademik 13.28HP Utech, MC Flemings: J. Appl. Fizik37, 2021 (1966)Çapraz ReferansGoogle Akademik 13.29HA Chedzey, DT Hurtle: Doğa210, 933 (1966)Çapraz ReferansGoogle Akademik 13.30K.Hoshi, T.Suzuki, Y.Okubo, N.Isawa: Dahili. soyut Elektrokimya. Soc. 157. Buluşma. (The Electrochemical Society, Pennington 1980) s.811Google Akademik 13.31M.Ohwa, T.Higuchi, E.Toji, M.Watanabe, K.Homma, S.Takasu: İçinde:Yarı İletken Silikon(The Electrochemical Society, Pennington 1986) s.117Google Akademik 13.32M.Futagami, K.Hoshi, N.Isawa, T.Suzuki, Y.Okubo, Y.Kato, Y.Okamoto: İçinde:Yarı İletken Silikon(The Electrochemical Society, Pennington 1986) s.939Google Akademik 13.33T.Suzuki, N.Isawa, K.Hoshi, Y.Kato, Y.Okubo: İçinde:Yarı İletken Silikon(The Electrochemical Society, Pennington 1986) s.142Google Akademik 13.34W.Zulehner: İçinde:Yarı İletken Silikon(The Electrochemical Society, Pennington 1990) s.30Google Akademik 13.35Y.Arai, M.Kida, N.Ono, K.Abe, N.Machida, H.Futuya, K.Sahira: İçinde:Yarı İletken Silikon(The Electrochemical Society, Pennington 1994) s.180Google Akademik 13.36F. Shimura: İçinde:VLSI Bilim ve Teknoloji(The Electrochemical Society, Pennington 1982) s. 17Google Akademik 13.37S.Chandrasekhar, KMKim: İçinde:Yarı İletken Silikon(The Electrochemical Society, Pennington 1998) s.411Google Akademik 13.38K. Hoshikawa, X. Huang, T. Taishi, T. Kajigaya, T. Iino: Jpn. J. Uygulama Fizik38, L1369 (1999)Çapraz ReferansGoogle Akademik 13.39KM Kim, P. Smetana: J. Cryst. Büyüme100, 527 (1989)Çapraz ReferansGoogle Akademik13.1genel bakış

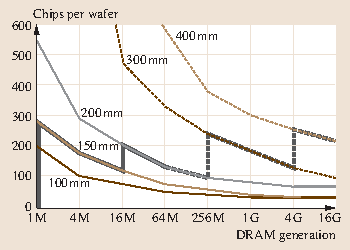
13.2Başlangıç Malzemeleri
13.2.1Metalurjik Dereceli Silikon
Yüksek saflıkta silikon tek kristaller için başlangıç malzemesi silikadır (SiO2). Silisyum üretimindeki ilk adım, silikanın eritilmesi ve indirgenmesidir. Bu, silika ve karbonun kömür, kok veya odun yongaları biçiminde karıştırılması ve karışımın daldırılmış elektrot ark fırınında yüksek sıcaklıklara ısıtılmasıyla gerçekleştirilir. Silikanın bu karbotermik indirgenmesi kaynaşmış silikon üretir.13.2.2Polikristal Silikon
Ara Kimyasal Bileşikler
Silikonun Hidroklorinasyonu
Triklorosilan, toz haline getirilmiş MG-Si'nin yaklaşık 300°C'de ısıtılmasıyla sentezlenir.∘Akışkan yataklı reaktörde C. Yani, MG-Si, SiHCl'ye dönüştürülür.3aşağıdaki reaksiyona göreTriklorosilanın Damıtma ve Ayrışması
Damıtma, triklorosilanı saflaştırmak için yaygın olarak kullanılmıştır. Kaynama noktası düşük olan triklorosilan (31.8)∘C), saf olmayan halojenürlerden fraksiyonel olarak damıtılır ve 1 ppba'dan daha az elektriksel olarak aktif safsızlık konsantrasyonu ile büyük ölçüde artan saflık ile sonuçlanır. Yüksek saflıkta triklorosilan daha sonra buharlaştırılır, yüksek saflıkta hidrojen ile seyreltilir ve biriktirme reaktörüne verilir. Reaktörde, reaksiyona göre silikonun yüzey biriktirilmesi için grafit elektrotlarla desteklenen ince çubuklar adı verilen ince silikon çubuklar mevcuttur.monosilan Prosesi
Granül Polisilikon Biriktirme
13.3Tek Kristal Büyüme
Polisilikon tekli silikon kristallerine dönüştürmek için çeşitli teknikler kullanılmış olsa da, mikroelektronik cihaz endüstrisinin gereksinimlerini karşıladıkları için elektronik üretiminde iki teknik hakim olmuştur. Biri, yaygın olarak adlandırılan azon eritme yöntemidir.yüzer bölge (FZ) yöntemdiğeri ise geleneksel olarak adlandırılan çekme yöntemidir.Czochralski (CZ) yöntemolarak adlandırılması gerekmesine rağmen,Teal-Little yöntemi. Bu iki kristal büyütme yönteminin arkasındaki prensipler Şekil 1'de gösterilmektedir.13.3. FZ yönteminde, amolten bölge, tek kristalli külçeye dönüştürmek için polisilisyum çubuktan geçirilir; CZ yönteminde tek kristal, aquartz pota içerisinde bulunan ameltten çekilerek büyütülür. Her iki durumda da,tohum kristaliistenen kristalografik yönelime sahip tek bir kristal elde etmede çok önemli bir rol oynar.
13.3.1Kayan Bölge Yöntemi
Genel açıklamalar
Sürecin Anahatları


Doping
FZ-Silikon Kristalinin Özellikleri
13.3.2Czochralski Yöntemi
Genel açıklamalar
Sürecin Anahatları
CZ kristal büyümesindeki en önemli üç adım, Şekil 2'de şematik olarak gösterilmiştir.13.3b. Prensipte, CZ büyüme süreci FZ büyümesine benzer: (1) polisilikon eritme, (2) tohumlama ve (3) büyütme. Bununla birlikte, CZ çekme prosedürü, FZ büyütmesinden daha karmaşıktır ve erimiş silikonu içermek için aquartz pota kullanımı ile ondan ayırt edilir. Şekil13.6tipik modern CZ kristal büyütme ekipmanının şematik görünümünü gösterir. Gerçek veya standart CZ silikon kristal büyüme dizisindeki önemli adımlar aşağıdaki gibidir:
Şekil13.7büyütülmüş bir CZ silikon kristalinin tohum ucu kısmını gösterir. Tohumdan silindirik kısma geçiş bölgesi olan tohum-mısır, ekonomik nedenlerle genellikle oldukça düz olarak oluşturulsa da, kristal kalite açısından daha konik bir şekil tercih edilebilir. Omuz kısmı ve çevresi, birçok anlamda geçiş bölgesi olarak kabul edildiğinden ve büyüme koşullarındaki ani değişiklik nedeniyle homojen olmayan kristal özellikler sergilediği için cihaz üretimi için kullanılmamalıdır.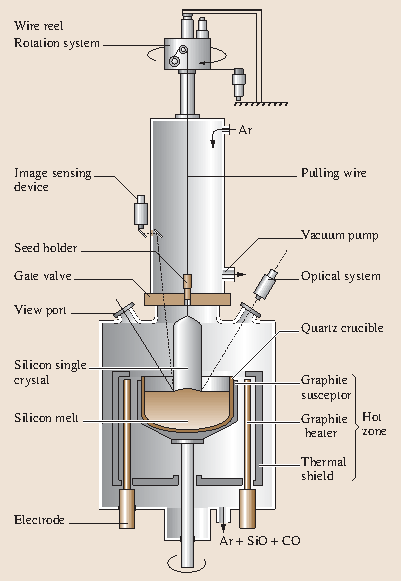
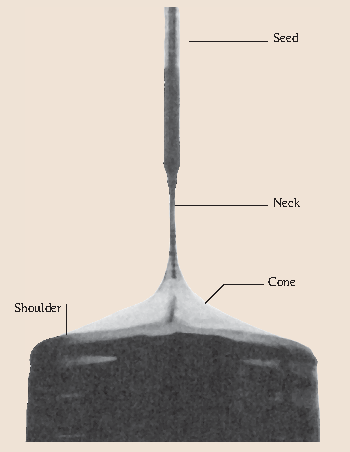

Mekânsal Konumun Etkisi inaGrownCrystal
Şekil olarak13.9aCZ kristalinin her bir parçasının farklı büyüme koşulları ile farklı zamanlarda büyütüldüğünü açıkça göstermektedir[13.19]. Bu nedenle, kristal uzunluğu boyunca farklı konumu nedeniyle her bölümün farklı bir kristal özellikleri kümesine ve farklı bir termal geçmişe sahip olduğunu anlamak önemlidir. Örneğin, tohum ucu kısmı, erime noktası 1420 ile yaklaşık 400 arasında değişen daha uzun bir termal geçmişe sahiptir.∘Apuller'de C, kuyruk ucu kısmı daha kısa bir geçmişe sahipken ve erime noktasından oldukça hızlı bir şekilde soğutulur. Sonuç olarak, büyümüş kristalin farklı bir bölümünden hazırlanan her bir silikon gofret, külçe içindeki konumuna bağlı olarak farklı fiziko-kimyasal özellikler sergileyebilir. Aslında, oksijen çökeltme davranışının en büyük konum bağımlılığını sergilediği ve bunun da toplu kusurların oluşumunu etkilediği bildirilmiştir.13.20].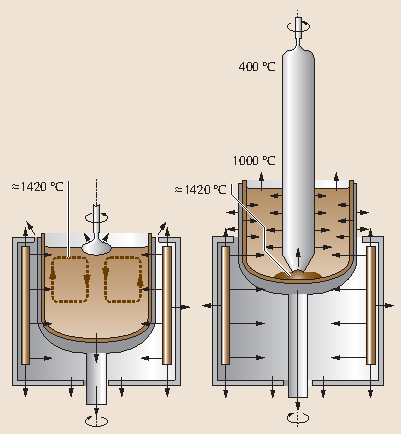
13.3.3Czochralski Silikonundaki Safsızlıklar
Kirlilik Homojenlik
segregasyon
çizgiler
Çoğu kristal büyüme prosesinde, anlık mikroskobik büyüme hızı ve difüzyon sınır tabakası kalınlığı gibi parametrelerde etkin ayrılma katsayısında değişikliklere neden olan geçici durumlar vardır.keff. Bu varyasyonlar, formda mikroskobik bileşimsel homojensizliklere yol açar.çizgilerkristal-eriyik arayüzüne paraleldir. Çizgiler, tercihli kimyasal aşındırma ve x-ışını topografisi gibi çeşitli tekniklerle kolayca tanımlanabilir. Şekil13.10aCZ silikon kristalinin uzunlamasına kesitinin omuz kısmında kimyasal aşındırma ile ortaya çıkan çizgileri gösterir. Büyüme ara yüzünün şeklindeki kademeli değişim de açıkça görülmektedir.

Doping
Yüksek difüzyon veya yüksek buhar basıncı, dopantların istenmeyen difüzyonuna veya buharlaşmasına yol açar, bu da cihazın dengesiz çalışmasına ve hassas direnç kontrolünün elde edilmesinde zorluklara neden olur. Çözünürlüğün çok küçük olması, elde edilebilecek özdirenci sınırlar. Bu kriterlere ek olarak, kimyasal özellikler (örneğin toksisite) dikkate alınmalıdır. Kristal büyümesi açısından başka bir değerlendirme, CZ kristal külçenin tohum ucundan kuyruk ucuna kadar direnci mümkün olduğu kadar tek biçimli kılmak için katkı maddesinin birliğe yakın bir agregasyon katsayısına sahip olmasıdır. Sonuç olarak, fosfor (P) ve bor (B), sırasıyla silikon için en yaygın olarak kullanılan verici ve alıcı katkı maddeleridir. n için+donör atomlarının yoğun bir şekilde katkılandığı silisyum, düşük segregasyon katsayısına ve hem eksenel hem de konsantrasyonda büyük değişikliklere yol açan yüksek buhar basıncına rağmen, daha küçük difüzivitesi nedeniyle genellikle fosfor yerine antimon (Sb) kullanılır. radyal yönler.Oksijen ve Karbon
Şekiller'de şematik olarak gösterildiği gibi.13.3grup13.6, aquartz (SiO2) CZ-Si kristal büyütme yönteminde pota ve grafit ısıtma elemanları kullanılmaktadır. Silikon eriyiği ile temas eden potanın yüzeyi reaksiyon nedeniyle yavaş yavaş çözülür.
13.4Yeni Kristal Büyüme Yöntemleri
Mikroelektronik cihaz üretimi için kullanılan silikon kristaller, cihaz üreticileri tarafından belirlenen çeşitli gereksinimleri karşılamalıdır. Silikon gereksinimlerine ek olarakgofretler, yüksek verimli ve yüksek performanslı mikro elektronik cihaz üretimi nedeniyle aşağıdaki kristalografik talepler daha yaygın hale geldi:
Silikon kristal üreticilerinin yalnızca yukarıdaki gereksinimleri karşılaması değil, aynı zamanda bu kristalleri ekonomik ve yüksek üretim verimleriyle üretmesi gerektiği açıktır. Silikon kristal yetiştiricilerinin ana endişeleri, kristalografik mükemmellik ve katkı maddelerinin CZ silikondaki eksenel dağılımıdır. Geleneksel CZ kristal büyütme yöntemiyle ilgili bazı sorunların üstesinden gelmek için birkaç yeni kristal büyütme yöntemi geliştirilmiştir.13.4.1AppliedMagneticField ile Czochralski Büyümesi (MCZ)
13.4.2Sürekli Czochralski Yöntemi (CCZ)
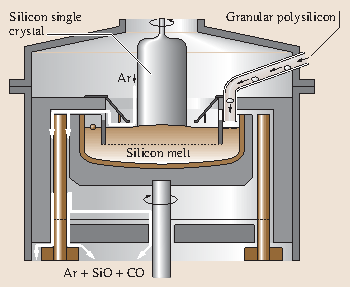
13.4.3Boyunsuz Büyüme Yöntemi
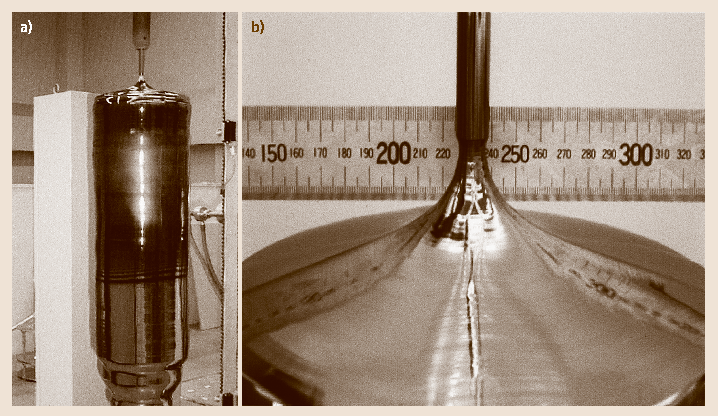
Referanslar

















